Introducció al carbur de silici
El carbur de silici (SiC) és un material semiconductor compost de carboni i silici, que és un dels materials ideals per fabricar dispositius d'alta temperatura, alta freqüència, alta potència i alt voltatge. En comparació amb el material de silici tradicional (Si), la banda prohibida del carbur de silici és 3 vegades superior a la del silici. La conductivitat tèrmica és de 4 a 5 vegades superior a la del silici; la tensió de ruptura és de 8 a 10 vegades superior a la del silici; la taxa de deriva de saturació electrònica és de 2 a 3 vegades superior a la del silici, cosa que satisfà les necessitats de la indústria moderna d'alta potència, alta tensió i alta freqüència. S'utilitza principalment per a la producció de components electrònics d'alta velocitat, alta freqüència, alta potència i emissors de llum. Els camps d'aplicació posteriors inclouen xarxes intel·ligents, vehicles de nova energia, energia eòlica fotovoltaica, comunicació 5G, etc. Els díodes i els MOSFET de carbur de silici s'han aplicat comercialment.

Resistència a altes temperatures. L'amplada de la banda prohibida del carbur de silici és de 2 a 3 vegades superior a la del silici, els electrons no tenen fàcil transició a altes temperatures i poden suportar temperatures de funcionament més elevades, i la conductivitat tèrmica del carbur de silici és de 4 a 5 vegades superior a la del silici, cosa que facilita la dissipació de calor del dispositiu i eleva la temperatura límit de funcionament. La resistència a altes temperatures pot augmentar significativament la densitat de potència alhora que redueix els requisits del sistema de refrigeració, fent que el terminal sigui més lleuger i petit.
Suportar alta pressió. La força de ruptura del camp elèctric del carbur de silici és 10 vegades superior a la del silici, que pot suportar tensions més altes i és més adequat per a dispositius d'alta tensió.
Resistència d'alta freqüència. El carbur de silici té una taxa de deriva d'electrons saturats dues vegades superior a la del silici, cosa que provoca l'absència de cues de corrent durant el procés d'apagada, cosa que pot millorar eficaçment la freqüència de commutació del dispositiu i aconseguir la miniaturització del dispositiu.
Baixa pèrdua d'energia. En comparació amb el material de silici, el carbur de silici té una resistència i pèrdues molt baixes. Al mateix temps, l'amplada de banda prohibida elevada del carbur de silici redueix considerablement el corrent de fuita i la pèrdua de potència. A més, el dispositiu de carbur de silici no té el fenomen de corrent de rastreig durant el procés d'apagada i la pèrdua de commutació és baixa.
Cadena de la indústria del carbur de silici
Inclou principalment substrat, epitaxial, disseny de dispositius, fabricació, segellat, etc. El carbur de silici des del material fins al dispositiu de potència semiconductor experimentarà creixement de monocristall, tall de lingots, creixement epitaxial, disseny d'oblies, fabricació, envasament i altres processos. Després de la síntesi de la pols de carbur de silici, primer es fabrica el lingot de carbur de silici, i després s'obté el substrat de carbur de silici mitjançant tall, mòlta i poliment, i la làmina epitaxial s'obté mitjançant creixement epitaxial. L'oblia epitaxial està feta de carbur de silici mitjançant litografia, gravat, implantació iònica, passivació metàl·lica i altres processos, l'oblia es talla en matriu, s'envasa el dispositiu i el dispositiu es combina en una carcassa especial i s'acobla en un mòdul.
Aigües amunt de la cadena industrial 1: substrat - el creixement de cristalls és l'enllaç central del procés
El substrat de carbur de silici representa aproximadament el 47% del cost dels dispositius de carbur de silici, les barreres tècniques de fabricació més altes, el valor més gran, és el nucli de la futura industrialització a gran escala del SiC.
Des de la perspectiva de les diferències en les propietats electroquímiques, els materials de substrat de carbur de silici es poden dividir en substrats conductors (regió de resistivitat 15~30 mΩ·cm) i substrats semiaïllats (resistivitat superior a 105 Ω·cm). Aquests dos tipus de substrats s'utilitzen per fabricar dispositius discrets com ara dispositius d'alimentació i dispositius de radiofreqüència, respectivament, després del creixement epitaxial. Entre ells, el substrat de carbur de silici semiaïllat s'utilitza principalment en la fabricació de dispositius RF de nitrur de gal·li, dispositius fotoelèctrics, etc. Mitjançant el creixement d'una capa epitaxial de gan sobre un substrat SIC semiaïllat, es prepara la placa epitaxial de sic, que es pot preparar posteriorment en dispositius RF d'isonitrur de gan HEMT. El substrat conductor de carbur de silici s'utilitza principalment en la fabricació de dispositius d'alimentació. A diferència del procés tradicional de fabricació de dispositius d'alimentació de silici, el dispositiu d'alimentació de carbur de silici no es pot fabricar directament sobre el substrat de carbur de silici, la capa epitaxial de carbur de silici s'ha de fer créixer sobre el substrat conductor per obtenir la làmina epitaxial de carbur de silici, i la capa epitaxial es fabrica sobre el díode Schottky, MOSFET, IGBT i altres dispositius d'alimentació.
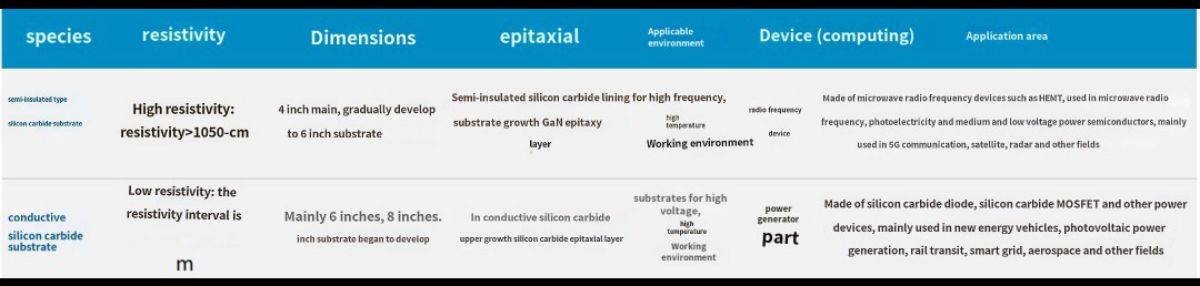
La pols de carbur de silici es va sintetitzar a partir de pols de carboni d'alta puresa i pols de silici d'alta puresa, i es van cultivar lingots de carbur de silici de diferents mides sota un camp de temperatura especial, i després es va produir el substrat de carbur de silici mitjançant múltiples processos de processament. El procés principal inclou:
Síntesi de matèries primeres: la pols de silici d'alta puresa + tòner es barreja segons la fórmula i la reacció es duu a terme a la cambra de reacció a alta temperatura per sobre de 2000 °C per sintetitzar les partícules de carbur de silici amb un tipus de cristall i una mida de partícula específics. A continuació, es tritura, es filtra, es neteja i altres processos per complir els requisits de matèries primeres de pols de carbur de silici d'alta puresa.
El creixement de cristalls és el procés central de la fabricació de substrats de carbur de silici, que determina les propietats elèctriques del substrat de carbur de silici. Actualment, els principals mètodes per al creixement de cristalls són la transferència física de vapor (PVT), la deposició química de vapor a alta temperatura (HT-CVD) i l'epitàxia en fase líquida (LPE). Entre ells, el mètode PVT és el mètode principal per al creixement comercial de substrats de SiC actualment, amb la maduresa tècnica més alta i el més utilitzat en enginyeria.

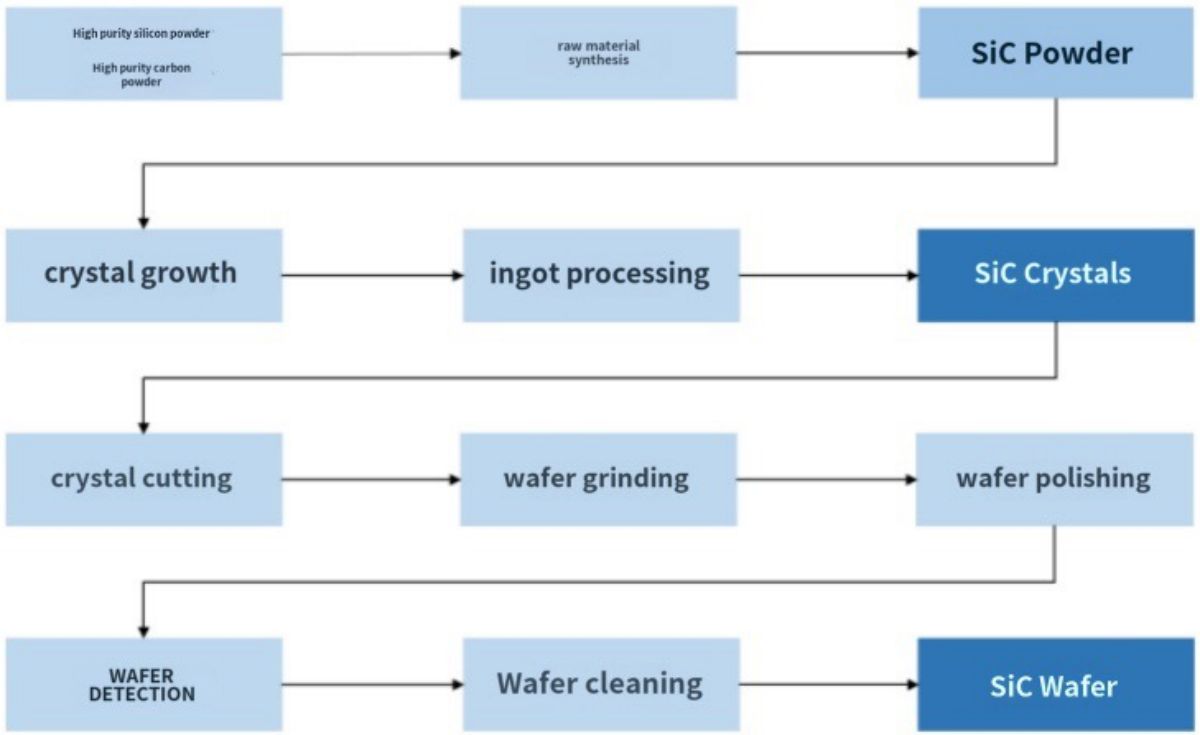
La preparació del substrat de SiC és difícil, cosa que comporta el seu elevat preu.
El control del camp de temperatura és difícil: el creixement de la vareta de cristall de Si només necessita 1500 ℃, mentre que la vareta de cristall de SiC s'ha de fer créixer a una temperatura superior a 2000 ℃, i hi ha més de 250 isòmers de SiC, però la principal estructura monocristallina 4H-SiC per a la producció de dispositius d'energia, si no es controla amb precisió, obtindrà altres estructures cristal·lines. A més, el gradient de temperatura al gresol determina la velocitat de transferència de sublimació de SiC i la disposició i el mode de creixement dels àtoms gasosos a la interfície del cristall, cosa que afecta la velocitat de creixement del cristall i la qualitat del cristall, per la qual cosa cal formar una tecnologia sistemàtica de control del camp de temperatura. En comparació amb els materials de Si, la diferència en la producció de SiC també rau en processos d'alta temperatura com la implantació d'ions d'alta temperatura, l'oxidació d'alta temperatura, l'activació d'alta temperatura i el procés de màscara dura requerit per aquests processos d'alta temperatura.
Creixement lent del cristall: la taxa de creixement de la vareta de cristall de Si pot arribar als 30 ~ 150 mm/h, i la producció d'una vareta de cristall de silici d'1-3 m només triga aproximadament 1 dia; La vareta de cristall de SiC amb el mètode PVT com a exemple, la taxa de creixement és d'uns 0,2-0,4 mm/h, 7 dies per créixer menys de 3-6 cm, la taxa de creixement és inferior a l'1% del material de silici, la capacitat de producció és extremadament limitada.
Paràmetres de producte elevats i baix rendiment: els paràmetres principals del substrat de SiC inclouen la densitat de microtúbuls, la densitat de dislocacions, la resistivitat, la deformació, la rugositat superficial, etc. És una enginyeria de sistemes complexa per organitzar els àtoms en una cambra tancada d'alta temperatura i completar el creixement del cristall, alhora que es controlen els índexs dels paràmetres.
El material té una duresa elevada, una fragilitat elevada, un temps de tall llarg i un desgast elevat: la duresa Mohs del SiC de 9,25 només és superada pel diamant, cosa que comporta un augment significatiu de la dificultat de tallar, esmolar i polir, i es triguen aproximadament 120 hores a tallar entre 35 i 40 peces d'un lingot de 3 cm de gruix. A més, a causa de l'alta fragilitat del SiC, el desgast del processament de les oblies serà major i la relació de producció és només d'un 60%.
Tendència de desenvolupament: Augment de la mida + disminució del preu
La línia de producció de volum de 6 polzades del mercat global de SiC està madurant i les empreses líders han entrat al mercat de 8 polzades. Els projectes de desenvolupament nacionals són principalment de 6 polzades. Actualment, tot i que la majoria de les empreses nacionals encara es basen en línies de producció de 4 polzades, la indústria s'està expandint gradualment a 6 polzades. Amb la maduresa de la tecnologia d'equips de suport de 6 polzades, la tecnologia de substrats de SiC nacional també està millorant gradualment, les economies d'escala de les línies de producció de gran mida es reflectiran i l'actual interval de temps de producció en massa nacional de 6 polzades s'ha reduït a 7 anys. La mida més gran de la làmina pot provocar un augment del nombre de xips individuals, millorar la taxa de rendiment i reduir la proporció de xips de vora, i el cost de la investigació i el desenvolupament i la pèrdua de rendiment es mantindran al voltant del 7%, millorant així la utilització de la làmina.
Encara hi ha moltes dificultats en el disseny de dispositius
La comercialització del díode SiC està millorant gradualment. Actualment, diversos fabricants nacionals han dissenyat productes SiC SBD. Els productes SiC SBD de mitjana i alta tensió tenen una bona estabilitat. En l'OBC dels vehicles, l'ús de SiC SBD + SI IGBT per aconseguir una densitat de corrent estable. Actualment, no hi ha barreres en el disseny de patents dels productes SiC SBD a la Xina, i la diferència amb els països estrangers és petita.
Els SiC MOS encara tenen moltes dificultats, encara hi ha una bretxa entre els SiC MOS i els fabricants estrangers, i la plataforma de fabricació pertinent encara està en construcció. Actualment, ST, Infineon, Rohm i altres SiC MOS de 600-1700V han aconseguit la producció en massa i han signat i enviat amb moltes indústries manufactureres, mentre que el disseny actual de SiC MOS nacional ja s'ha completat bàsicament, diversos fabricants de disseny estan treballant amb fàbriques en la fase de flux de la làmina, i la verificació posterior del client encara necessita temps, per la qual cosa encara queda molt de temps per a la comercialització a gran escala.
Actualment, l'estructura planar és l'opció principal, i el tipus de trinxera s'utilitzarà àmpliament en el camp d'alta pressió en el futur. Hi ha molts fabricants de SiC MOS d'estructura planar, l'estructura planar no és fàcil de produir problemes de ruptura local en comparació amb la ranura, cosa que afecta l'estabilitat del treball, al mercat per sota de 1200V té una àmplia gamma de valor d'aplicació, i l'estructura planar és relativament senzilla en la fabricació final, per satisfer dos aspectes de fabricabilitat i control de costos. El dispositiu de ranura té els avantatges d'una inductància paràsit extremadament baixa, una velocitat de commutació ràpida, baixes pèrdues i un rendiment relativament alt.
2 -- Notícies sobre oblies de SiC
Creixement de la producció i les vendes del mercat de carbur de silici, presteu atenció al desequilibri estructural entre l'oferta i la demanda


Amb el ràpid creixement de la demanda del mercat d'electrònica de potència d'alta freqüència i alta potència, el coll d'ampolla del límit físic dels dispositius semiconductors basats en silici ha anat adquirint importància gradualment, i els materials semiconductors de tercera generació representats pel carbur de silici (SiC) s'han anat industrialitzant gradualment. Des del punt de vista del rendiment del material, el carbur de silici té 3 vegades l'amplada de la banda prohibida del material de silici, 10 vegades la força del camp elèctric de ruptura crítica i 3 vegades la conductivitat tèrmica, de manera que els dispositius de potència de carbur de silici són adequats per a aplicacions d'alta freqüència, alta pressió, alta temperatura i altres, i ajuden a millorar l'eficiència i la densitat de potència dels sistemes electrònics de potència.
Actualment, els díodes SiC i els MOSFET SiC han anat entrant gradualment al mercat, i hi ha productes més madurs, entre els quals els díodes SiC s'utilitzen àmpliament en lloc dels díodes basats en silici en alguns camps perquè no tenen l'avantatge de la càrrega de recuperació inversa; El MOSFET SiC també s'utilitza gradualment en automoció, emmagatzematge d'energia, pila de càrrega, fotovoltaica i altres camps; En el camp de les aplicacions d'automoció, la tendència a la modularització és cada cop més destacada, el rendiment superior del SiC ha de dependre de processos d'envasament avançats per aconseguir-ho, tècnicament amb un segellat de carcassa relativament madur com a corrent principal, el futur o el desenvolupament del segellat de plàstic, les seves característiques de desenvolupament personalitzades són més adequades per als mòduls SiC.
Velocitat de caiguda del preu del carbur de silici o més enllà de la imaginació

L'aplicació de dispositius de carbur de silici està limitada principalment per l'alt cost. El preu del MOSFET de SiC per sota del mateix nivell és 4 vegades superior al de l'IGBT basat en Si. Això es deu al fet que el procés del carbur de silici és complex, en què el creixement del monocristall i l'epitaxial no només és dur per al medi ambient, sinó que també la taxa de creixement és lenta, i el processament del monocristall en el substrat ha de passar pel procés de tall i polit. A causa de les seves pròpies característiques materials i la tecnologia de processament immadura, el rendiment del substrat domèstic és inferior al 50%, i diversos factors condueixen a preus elevats del substrat i de l'epitaxial.
Tanmateix, la composició de costos dels dispositius de carbur de silici i els dispositius basats en silici és diametralment oposada: els costos del substrat i l'epitaxial del canal frontal representen el 47% i el 23% de tot el dispositiu respectivament, amb un total d'aproximadament el 70%; el disseny, la fabricació i el segellat del dispositiu del canal posterior representen només el 30%; el cost de producció dels dispositius basats en silici es concentra principalment en la fabricació de les oblies del canal posterior, al voltant del 50%, i el cost del substrat només representa el 7%. El fenomen del valor de la cadena industrial del carbur de silici cap per avall significa que els fabricants d'epitaxial de substrats aigües amunt tenen el dret fonamental de parlar, cosa que és clau per al disseny de les empreses nacionals i estrangeres.
Des del punt de vista dinàmic del mercat, la reducció del cost del carbur de silici, a més de millorar el procés de tall i cristall llarg de carbur de silici, significa ampliar la mida de la làmina, que també és el camí madur del desenvolupament de semiconductors en el passat. Les dades de Wolfspeed mostren que l'actualització del substrat de carbur de silici de 6 polzades a 8 polzades, la producció de xips qualificats pot augmentar entre un 80% i un 90% i ajudar a millorar el rendiment. Pot reduir el cost unitari combinat en un 50%.
El 2023 es coneix com el "primer any del SiC de 8 polzades". Aquest any, els fabricants nacionals i estrangers de carbur de silici estan accelerant el disseny del carbur de silici de 8 polzades, com ara la inversió esbojarrada de Wolfspeed de 14.550 milions de dòlars americans per a l'expansió de la producció de carbur de silici, una part important de la qual és la construcció d'una planta de fabricació de substrats de SiC de 8 polzades. Per garantir el subministrament futur de metall nu de SiC de 200 mm a diverses empreses, Tianyue Advanced i Tianke Heda també han signat acords a llarg termini amb Infineon per subministrar substrats de carbur de silici de 8 polzades en el futur.
A partir d'aquest any, el carbur de silici accelerarà de 6 polzades a 8 polzades. Wolfspeed preveu que, el 2024, el cost unitari del xip del substrat de 8 polzades en comparació amb el cost unitari del xip del substrat de 6 polzades el 2022 es reduirà en més d'un 60%, i la disminució del cost obrirà encara més el mercat de les aplicacions, segons les dades de recerca de Ji Bond Consulting. La quota de mercat actual dels productes de 8 polzades és inferior al 2%, i s'espera que la quota de mercat creixi fins a aproximadament el 15% el 2026.
De fet, la taxa de disminució del preu del substrat de carbur de silici pot superar la imaginació de molta gent, l'oferta actual del mercat de substrats de 6 polzades és de 4000-5000 iuans/unitat, en comparació amb l'inici de l'any ha caigut molt, s'espera que caigui per sota dels 4000 iuans l'any que ve, val la pena assenyalar que alguns fabricants per aconseguir el primer mercat, han reduït el preu de venda a la línia de cost per sota, va obrir el model de la guerra de preus, concentrada principalment en el subministrament de substrats de carbur de silici ha estat relativament suficient en el camp de baixa tensió, els fabricants nacionals i estrangers estan ampliant agressivament la capacitat de producció, o deixant que l'etapa d'excés d'oferta de substrats de carbur de silici sigui abans del que s'imaginava.
Data de publicació: 19 de gener de 2024
