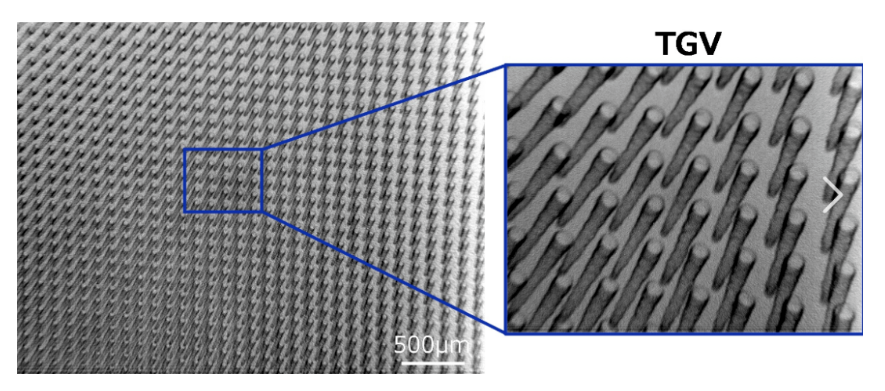
Què és el TGV?
TGV (via a través del vidre), una tecnologia per crear forats passants en un substrat de vidre. En termes senzills, un TGV és un edifici alt que perfora, omple i connecta amunt i avall el vidre per construir circuits integrats al terra de vidre. Aquesta tecnologia es considera una tecnologia clau per a la propera generació d'envasos 3D.

Quines són les característiques del TGV?
1. Estructura: El TGV és un forat conductor de penetració vertical fet sobre un substrat de vidre. En dipositar una capa metàl·lica conductora a la paret del porus, les capes superior i inferior dels senyals elèctrics estan interconnectades.
2. Procés de fabricació: la fabricació de TGV inclou el pretractament del substrat, la realització de forats, la deposició de capes metàl·liques, l'ompliment de forats i els passos d'aplanament. Els mètodes de fabricació habituals són el gravat químic, la perforació làser, la galvanoplàstia, etc.
3. Avantatges de l'aplicació: en comparació amb el forat metàl·lic tradicional, el TGV té els avantatges d'una mida més petita, una densitat de cablejat més alta, un millor rendiment de dissipació de calor, etc. S'utilitza àmpliament en microelectrònica, optoelectrònica, MEMS i altres camps d'interconnexió d'alta densitat.
4. Tendència de desenvolupament: Amb el desenvolupament de productes electrònics cap a la miniaturització i l'alta integració, la tecnologia TGV rep cada cop més atenció i aplicació. En el futur, el seu procés de fabricació continuarà optimitzant-se i la seva mida i rendiment continuaran millorant.
Què és el procés TGV:
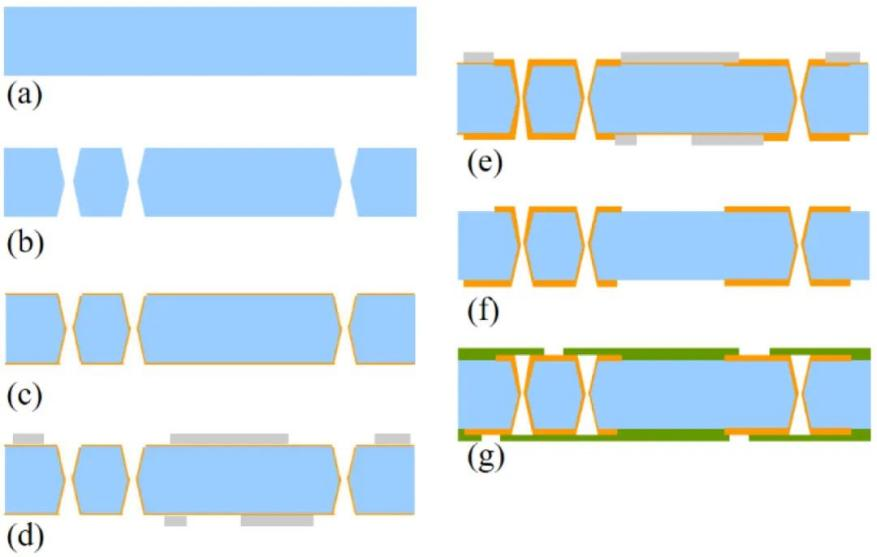
1. Preparació del substrat de vidre (a): Prepareu un substrat de vidre al principi per assegurar-vos que la seva superfície sigui llisa i neta.
2. Perforació del vidre (b): S'utilitza un làser per formar un forat de penetració al substrat de vidre. La forma del forat és generalment cònica i, després del tractament amb làser per un costat, es gira i es processa per l'altre costat.
3. Metal·lització de la paret del forat (c): La metal·lització es duu a terme a la paret del forat, generalment mitjançant PVD, CVD i altres processos per formar una capa de llavor metàl·lica conductora a la paret del forat, com ara Ti/Cu, Cr/Cu, etc.
4. Litografia (d): La superfície del substrat de vidre es recobreix amb fotoresina i es fotoestampa. S'exposen les parts que no necessiten ser recobertes, de manera que només quedin exposades les parts que sí que ho necessiten.
5. Ompliment de forats (e): galvanitzar coure per omplir el vidre a través dels forats per formar una via conductora completa. Generalment es requereix que el forat estigui completament omplert sense forats. Tingueu en compte que el Cu del diagrama no està completament poblat.
6. Superfície plana del substrat (f): Alguns processos TGV aplanen la superfície del substrat de vidre omplert per garantir que la superfície del substrat sigui llisa, cosa que afavoreix els passos posteriors del procés.
7. Capa protectora i connexió terminal (g): Es forma una capa protectora (com ara poliimida) a la superfície del substrat de vidre.
En resum, cada pas del procés TGV és crític i requereix un control i una optimització precisos. Actualment oferim tecnologia de forats passants per vidre TGV si cal. No dubteu a contactar amb nosaltres!
(La informació anterior prové d'Internet, censurada)
Data de publicació: 25 de juny de 2024
